MOS结构高频电容-电压特性(简称C-V特性)测量是检测MOS器件制造工艺的重要手段。它可以方便地确定二氧化硅层厚度dOX、衬底掺杂浓度N、氧化层中可动电荷面密度QI和固定电荷面密度Qfc等参数。
本实验目的是通过测量MOS结构高频C-V特性,确定二氧化硅层厚度dOX、衬底掺杂浓度N和可动电荷面密度QI等参数.
一、实 验 原 理
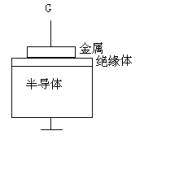
![]()

MOS结构如图1.1所示,它类似于金属和介质形成的平板电容器。但是
a.MOS结构示意图 b.等效电路 图1.2 p-Si MOS结构C-V特性
图1.1 MOS结构示意图和等效电路
,由于半导体中的电荷密度比金属中的小得多,所以充电电荷在半导体表面形成的空间电荷区有一定的厚度(~微米量级),而不象金属中那样,只集中在一薄层(∽0.1nm)内。半导体表面空间电荷区的厚度随偏压VG而改变,所以
![]() (1)
(1)
式中QG是金属电极上的电荷面密度,A是电极面积。考虑理想MOS结构,所谓理想情形,是假设MOS结构满足以下条件:(1)金属与半导体功函数差为零,(2)SiO2绝缘层内没有电荷,(3)SiO2与半导体界面处不存在界面态。偏压VG一部分降在SiO2上,记作VOX,一部分降在半导体表面空间电荷区,记作VS,即
VG=VOX+VS
(2)
VS又叫表面势。考虑到
![]() (3)
(3)
式中Qsc是半导体表面空间电荷区电荷面密度。将(2)、(3)代入(1)式,
 (4)
(4)
(4)式表明MOS电容由COX和Cs串联而成,其等效电路如图1.1(b)所示。其中COX是以SiO2为介质的氧化层电容,它的数值不随改变;Cs是半导体表面空间电荷区电容,其数值随VG改变,因此
 (5)
(5)
式中εr0是SiO2相对介电常数。
P型衬底理想MOS结构高频电容-电压特性曲线如图1.2所示。图中V代表偏压。最大电容Cmax≈COX,最小电容Cmin和最大电容Cmax之间有如下关系
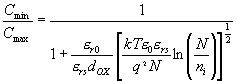 (6)
(6)
VS=0时,半导体表面能带平直,称为平带。平带时的MOS电容称为平带电容,记为CFB。对于给定的MOS结构,归一化平带电容由下式给出:
 (7)
(7)
显然,对于理想MOS结构,VFB=0。
考虑实际的MOS结构。由于SiO2中总是存在电荷(通常是正电荷),且金属的功函数Wm和半导体的功函数Ws通常并不相等,所以
VFB一般不为零。若不考虑界面态的影响,有
![]() (8)
(8)
式中QOX是SiO2中电荷的等效面密度,它包括可动电荷QI和固定电荷Qfc二部分。“等效”是指把SiO2中随机分布的电荷对VFB的影响看成是集中在Si-SiO2界面处的电荷对VFB的影响。Vm-s是金属-半导体接触电势差,
![]() (9)
(9)

图1.3 p-Si MOS结构的高频C-V特性
对于铝栅p型Si MOS结构,Vm-s>0, QOX通常也>0(正电荷),所以VFB<0,如图1.3中的曲线所示.作为对比,图中还化出了相应的理想曲线(曲线0).
利用正、负偏压温度处理的方法(简称±BT处理)可将可动电荷QI和固定电荷Qfc区分开来。负BT处理是给样品加一定的负偏压(即VG<0),同时将样品加热到一定的温度.由于可动电荷(主要是带正电的Na+离子)在高温下有较大的迁移率,它们将在高温负偏压下向金属
- SiO2界面运动.经过一定的时间,可以认为SiO2中的可动电荷基本上全部运动到金属 - SiO2界面处保持偏压不变,将样品冷却至室温,然后去掉偏压,测量高频C-V特性,得到图3中的曲线2。由于这时可动电荷已经全部集中到金属-
SiO2界面处,对平带电压没有影响了,根据(8)式可得
 (10)
(10)
若Vms已知,由式(10)可以确定SiO2中的固定电荷
![]() (11)
(11)
改变偏压极性,作正BT处理。加热的温度和时间与负BT相同。正BT处理后,测量高频C-V特性,得到图3中的曲线3。由于这时可动电荷已基本上全部集中到Si -
SiO2界面处,所以VFB3中包括了QI和Qfc的影响。根据(8)和(10)式
![]()
![]() (12)
(12)
令 ![]()
由式(12)可确定可动电荷面密度
![]() (13)
(13)
二、实验仪器
1、测试台(包括样品台、探针、升
温和控温装置、水冷却装置等);
2、590型高频C-V测试仪;
3、软件;
4、微机

图2.1
实验仪器示意图
三、实验内容
测量MOS结构高频C-V特性,确定二氧化硅层厚度dOX、衬底掺杂浓度N和可动电荷面密度QI等参数。
四、实验步骤
主要包括七个步骤:
²
打开各仪器的电源,预热10分钟;
²
启动Metrics-ICS
² 设置IEEE-488(Setup GPIB)
²
设置测试仪器(Select
Instrument)
²
设置测试条件(Edit
test setup)
²
设置计算公式(如果有间接测量结果Transform editor)
²
执行测试(Measure)
²
图表分析、文件存档和打印
以下将给出包括直观性较强的界面在内的详细操作步骤:
u
人、机安全注意事项:
A、操作之前,请注意将机器正确接地;
B、检修之前,请注意按操作手册将C-V测试仪与电源线及其它
设备断开;
C、在测试仪器工作时,禁止触摸仪器的端口。
(详细安全信息请详细阅读操作手册)
四、实验数据处理
1、由初始C-V曲线,可获得Cmax和Cmin。利用式(5)和(6)可求出氧化层厚度
dox和衬底掺杂浓度N;
2、利用(7)式求出CFB;
3、由实验曲线确定VFB2、VFB3和ΔVFB;
4、计算求出Vms;
5、利用式(11)和(13)分别求出Qfc和QI
6、如果Qfc和QI较大(1011cm2量级或更大),分析一下原因(如Si片清洗不干净,氧化系统有沾污等),进而提出改进措施;
7、如果C-V曲线形状异常,可以配合界面态的测量来分析原因.